中科智芯完成多层(2-4)WLCSP产品下线、试生产启动
2020/09/18

近年来,随着移动电子产品趋向轻巧、多功能、低功耗发展,晶圆级芯片封装(WLCSP)已经得到业界的广泛关注,因其在体积、成本和性能等方面优势,目前已成功应用于移动通讯、医疗设备、射频模块、电源管理单元和GPS模块等领域。根据Yole Développement的数据显示,WLCSP市场份额在2019年就超过了20亿美元,并预计至2025年的年复合增长率为5%以上。
中科智芯看准了晶圆级芯片封装(WLCSP)未来发展的良好态势,加大研发与资金投入力度,积极开展WLCSP多层重布线技术的研发与产业化工作。目前,我司现已成功完成多层(2- 4层)重布线的WLCSP产品的研制,最近该类别的多种产品顺利下线,产品良率达到客户规定目标,我司已着手批量试生产工作。
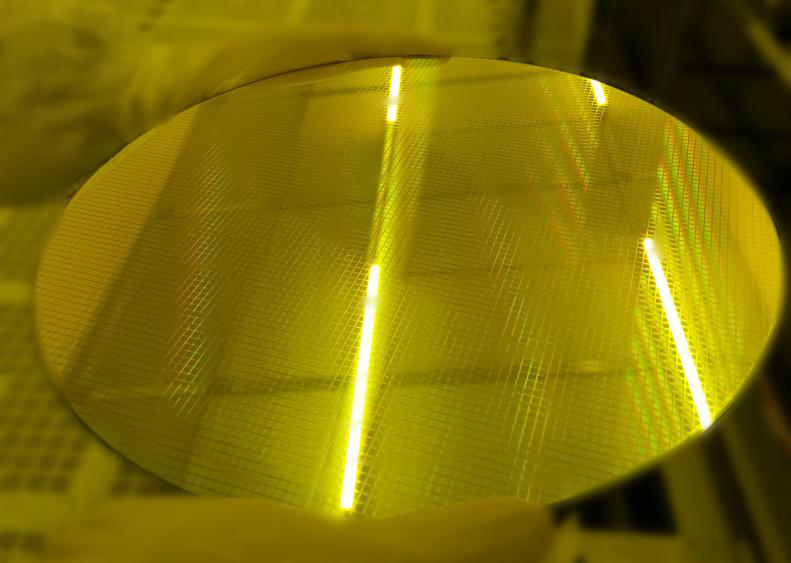
多层布线WLCSP晶圆

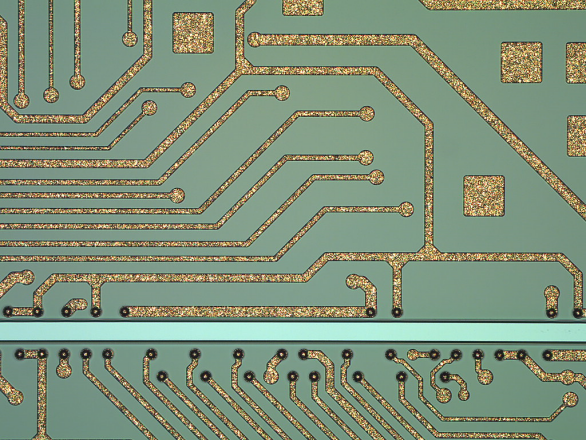
多层布线WLCSP技术局部线路图
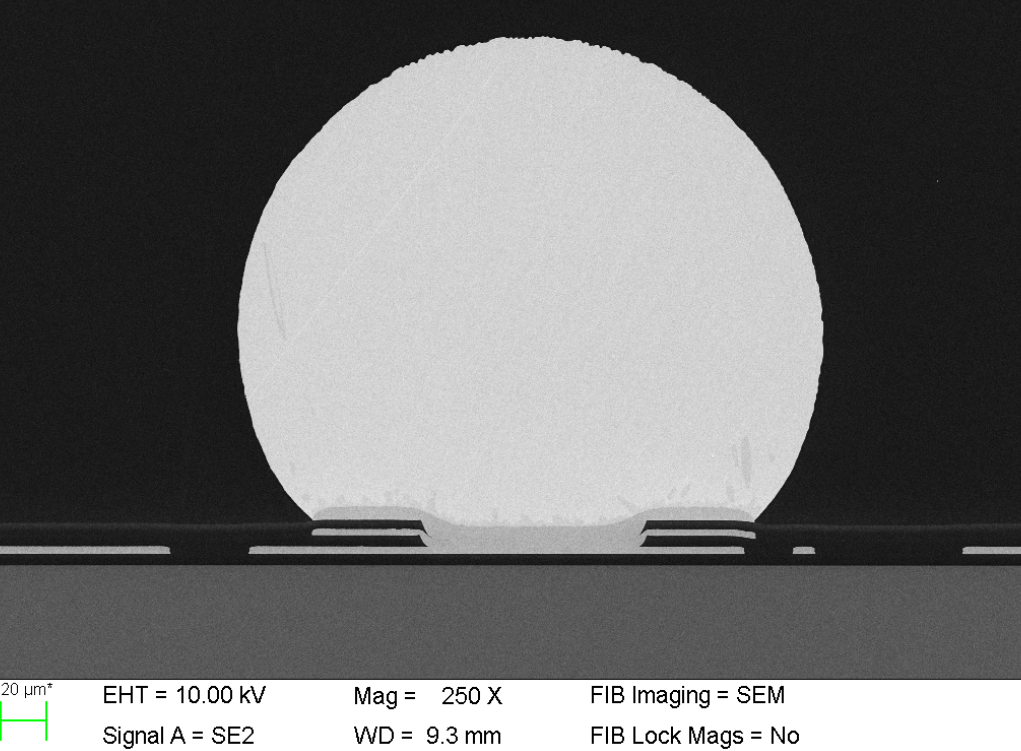
WLCSP产品截面图
本次下线的WLCSP技术主要解决了多层套刻、细线路精准加工、以及产品良率等问题,可应用于不同尺寸芯片的晶圆级封装工艺以及对电信号有特殊需求的产品。

 English
English